 Date: 2016-04-25 13:15:12Semiconductor device fabrication Microtechnology Etching Plasma processing Chemical milling Isotropic etching Plasma etching Microelectromechanical systems Buffered oxide etch | |  High-Aspect Ratio Deep Sub-Micron α-Si Gate Etch Process Control H.-M. Park, T. L. Brock, D. Grimard, J. W. Grizzle and F. L. Terry, Jr University of Michigan 195th Spring Meeting of ECS High-Aspect Ratio Deep Sub-Micron α-Si Gate Etch Process Control H.-M. Park, T. L. Brock, D. Grimard, J. W. Grizzle and F. L. Terry, Jr University of Michigan 195th Spring Meeting of ECS
Add to Reading ListSource URL: web.eecs.umich.eduDownload Document from Source Website File Size: 260,37 KBShare Document on Facebook
|





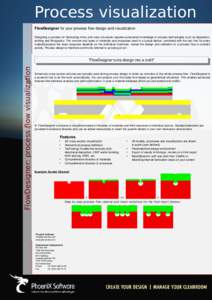
 High-Aspect Ratio Deep Sub-Micron α-Si Gate Etch Process Control H.-M. Park, T. L. Brock, D. Grimard, J. W. Grizzle and F. L. Terry, Jr University of Michigan 195th Spring Meeting of ECS
High-Aspect Ratio Deep Sub-Micron α-Si Gate Etch Process Control H.-M. Park, T. L. Brock, D. Grimard, J. W. Grizzle and F. L. Terry, Jr University of Michigan 195th Spring Meeting of ECS